Search
Semiconductor Analysis
Optical Fault Isolation
Semiconductor fault isolation techniques that enable failure analysis labs to localize electrical faults in devices.
Join the Conversation
Troubleshooting semiconductor device failure is critical for improving manufacturing yield, reducing costs, and minimizing overall end-of-line test failures. However, isolating faults and defects (e.g. opens, metal shorts, and leakages) in the failure analysis workflow is becoming more challenging due to increasingly complex semiconductor designs.
Optical fault isolation (OFI) is a type of electrical failure analysis that makes use of a variety of optical techniques (photon-emission, static laser stimulation, etc.) to detect the causes of device failure.
This can include both static and dynamic OFI:
| Static OFI techniques | Dynamic OFI techniques |
|---|---|
| Optical beam Induced resistance change (OBIRCH) | Laser voltage imaging (LVI) |
| Optical beam induced current (OBIC) | Laser Voltage Probing (LVP) |
| Light induced voltage alteration (LIVA) | Laser voltage tracing (LVT) |
| Thermally induced voltage alteration (TIVA) | Laser-assisted device alteration (LADA) |
| Static photon emission (PEM) | Soft defect localization (SDL) |
| Dynamic photon emission (PEM) |
Broadly, these techniques allow the user to analyze the performance of electrically active devices and locate critical defects that cause a device to fail. Understanding these defects, and then eliminating them from the manufacturing process, is crucial if modern fabs are to operate at high yield and profitability.
Thermo Fisher Scientific offers a variety of optical fault isolation systems as part of the Meridian product line. This includes all of the above OFI techniques, encompassing systems for both photon emission and laser stimulation applications. The Meridian product line consists of cost-effective, high-sensitivity solutions for localizing electrical failures in semiconductor devices, and is especially powerful when combined with other analysis workflows and solutions from Thermo Fisher Scientific's portfolio. Click through to the appropriate product pages below for more information.

Semiconductor research and development
Innovation starts with research and development. Learn more about solutions to help you understand innovative structures and materials at the atomic level.
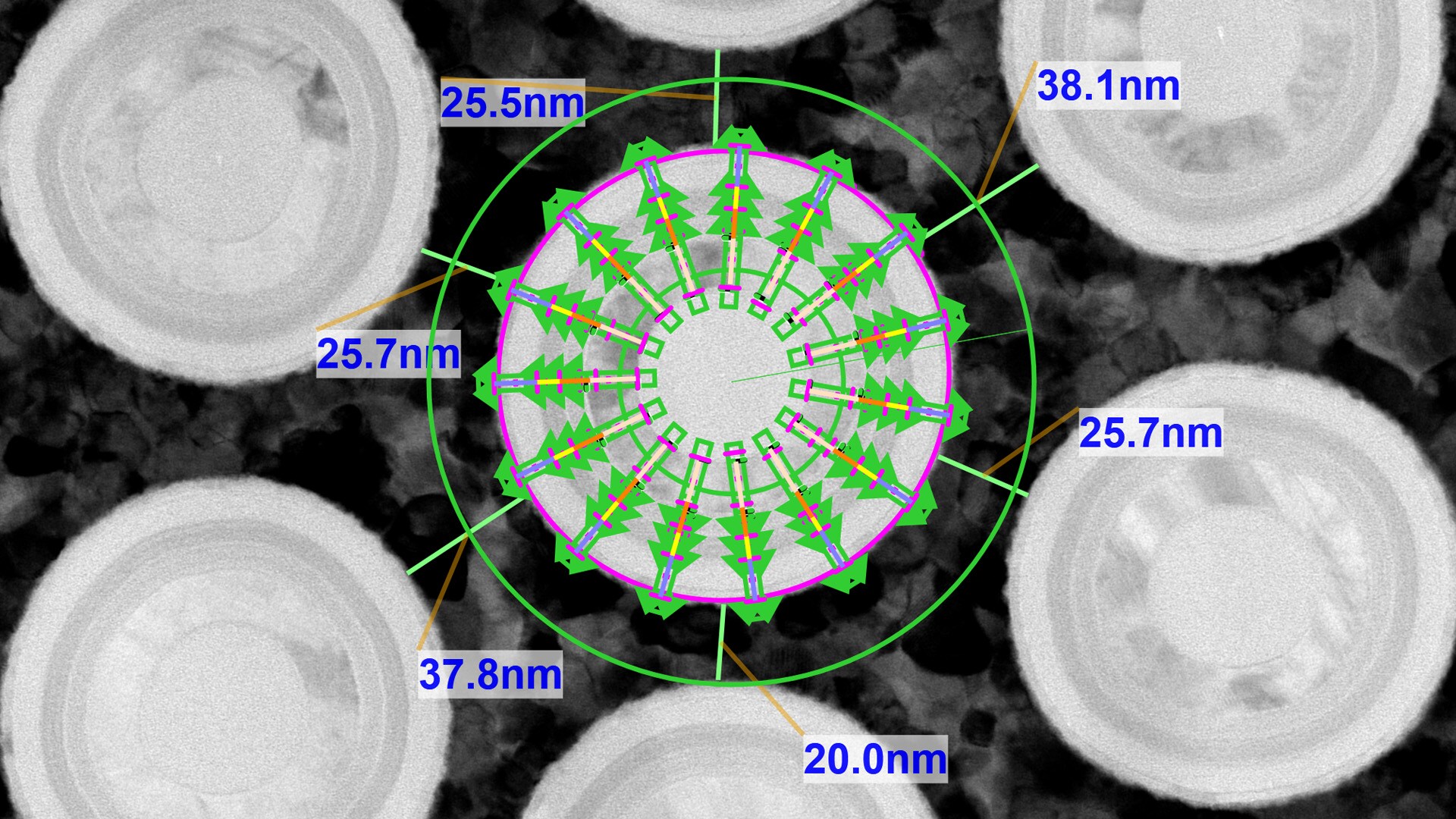
Semiconductor metrology
Manufacturing today’s complex semiconductors requires exact process controls. Learn more about advanced metrology and analysis solutions to accelerate yield learnings.
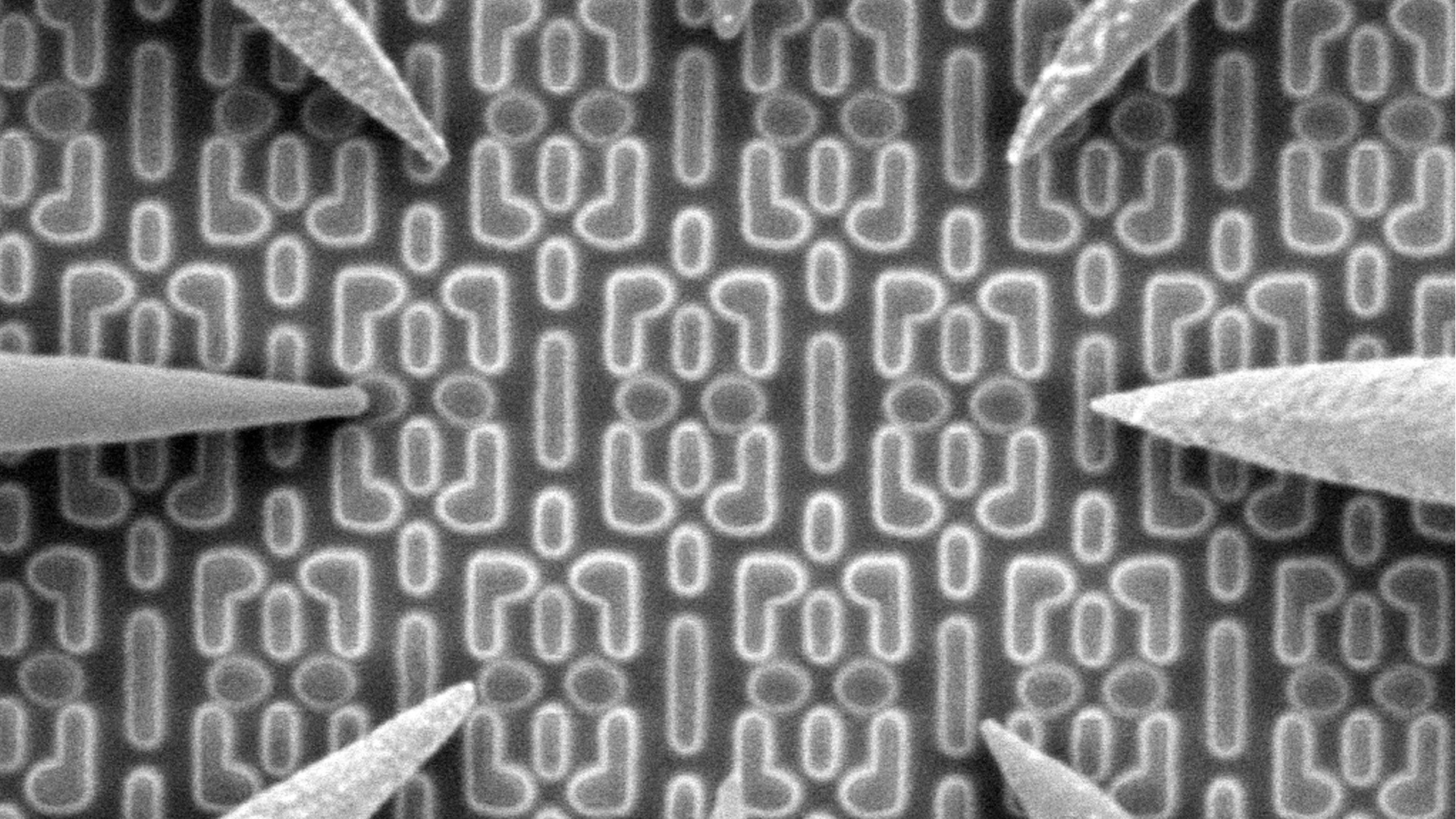
Semiconductor Failure Analysis
Complex semiconductor device structures result in more places for defects to hide. Learn more about failure analysis solutions to isolate, analyze, and repair defects.

Semiconductor materials characterization
Many factors impact yield, performance, and reliability. Learn more about solutions to characterize physical, structural, and chemical properties.

ESD Semiconductor Qualification
Every electrostatic discharge (ESD) control plan is required to identify devices that are sensitive to ESD. We offer a complete suite of test systems to help with your device qualification requirements.

Semiconductor power devices
Novel architectures and materials pose new challenges. Learn how to pinpoint faults and characterize materials, structures, and interfaces.
Semiconductor Materials and Device Characterization
As semiconductor devices shrink and become more complex, new designs and structures are needed. High-productivity 3D analysis workflows can shorten device development time, maximize yield, and ensure that devices meet the future needs of the industry.










