Search
Semiconductor Analysis
Semiconductor Materials and Device Characterization
Advanced semiconductor materials and device characterization solutions for logic, 3D NAND, DRAM, display, power, analog and MEMS devices.
Join the Conversation
The fabrication of nanostructures and architectures with uniform dimensions is highly desirable for developing functional semiconductor devices. As these devices shrink, the fabrication of new designs and more complex structures, using novel materials, is needed to meet corresponding challenges. To this end, highly sensitive and advanced analytical tools must be used to detect the slightest electrical issues that can influence yield or performance in these more advanced structures.
As an example, analysis might include isolating electrical faults that cause semiconductor devices to fail at end-of-line tests. Defects, like metal shorts, opens, and transistor-level leakages, are localized in the failure analysis workflow to identify and troubleshoot failures, increasing overall device manufacturing yield. This helps to improve cost-effectiveness, and provides high-sensitivity solutions for detecting electrical failures.
Thermo Fisher Scientific 3D analysis solutions and workflows offer high-productivity characterization on a broad range of devices and sample types - from packaged die, bare die, to 150 mm, 200 mm and 300 mm wafers.

Semiconductor Advanced Packaging
Performance, power efficiency, area, and cost are driving packaging innovations. Learn how workflows provide fast, precise, and accurate time-to-data.

Semiconductor research and development
Innovation starts with research and development. Learn more about solutions to help you understand innovative structures and materials at the atomic level.
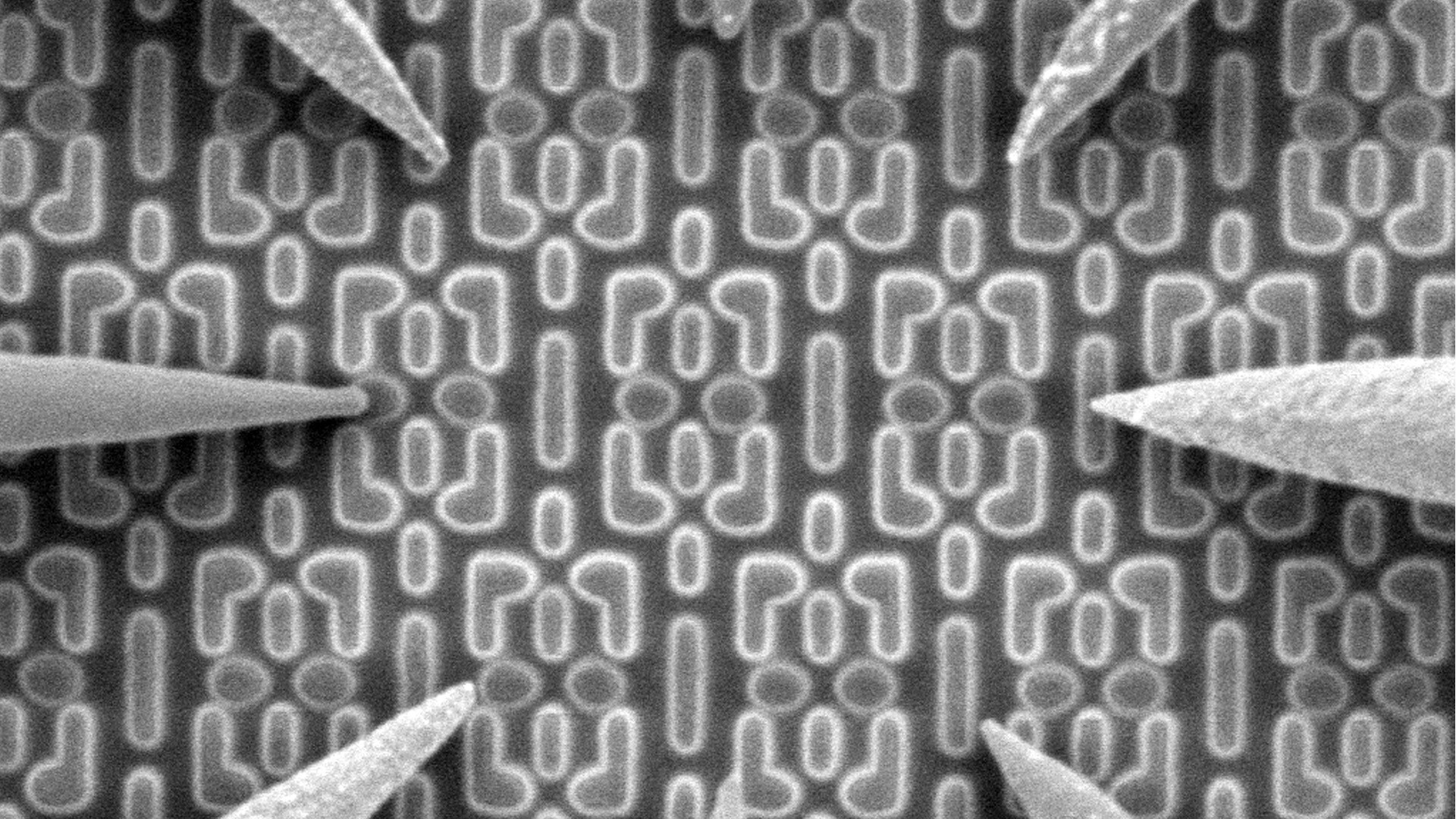
Semiconductor Failure Analysis
Complex semiconductor device structures result in more places for defects to hide. Learn more about failure analysis solutions to isolate, analyze, and repair defects.

Semiconductor materials characterization
Many factors impact yield, performance, and reliability. Learn more about solutions to characterize physical, structural, and chemical properties.

ESD Semiconductor Qualification
Every electrostatic discharge (ESD) control plan is required to identify devices that are sensitive to ESD. We offer a complete suite of test systems to help with your device qualification requirements.

Semiconductor Memory Devices
Data demands are driving 3D NAND, DRAM and other memory structure innovations. Learn how analysis tools and workflows offer accurate visibility of buried features and defects.
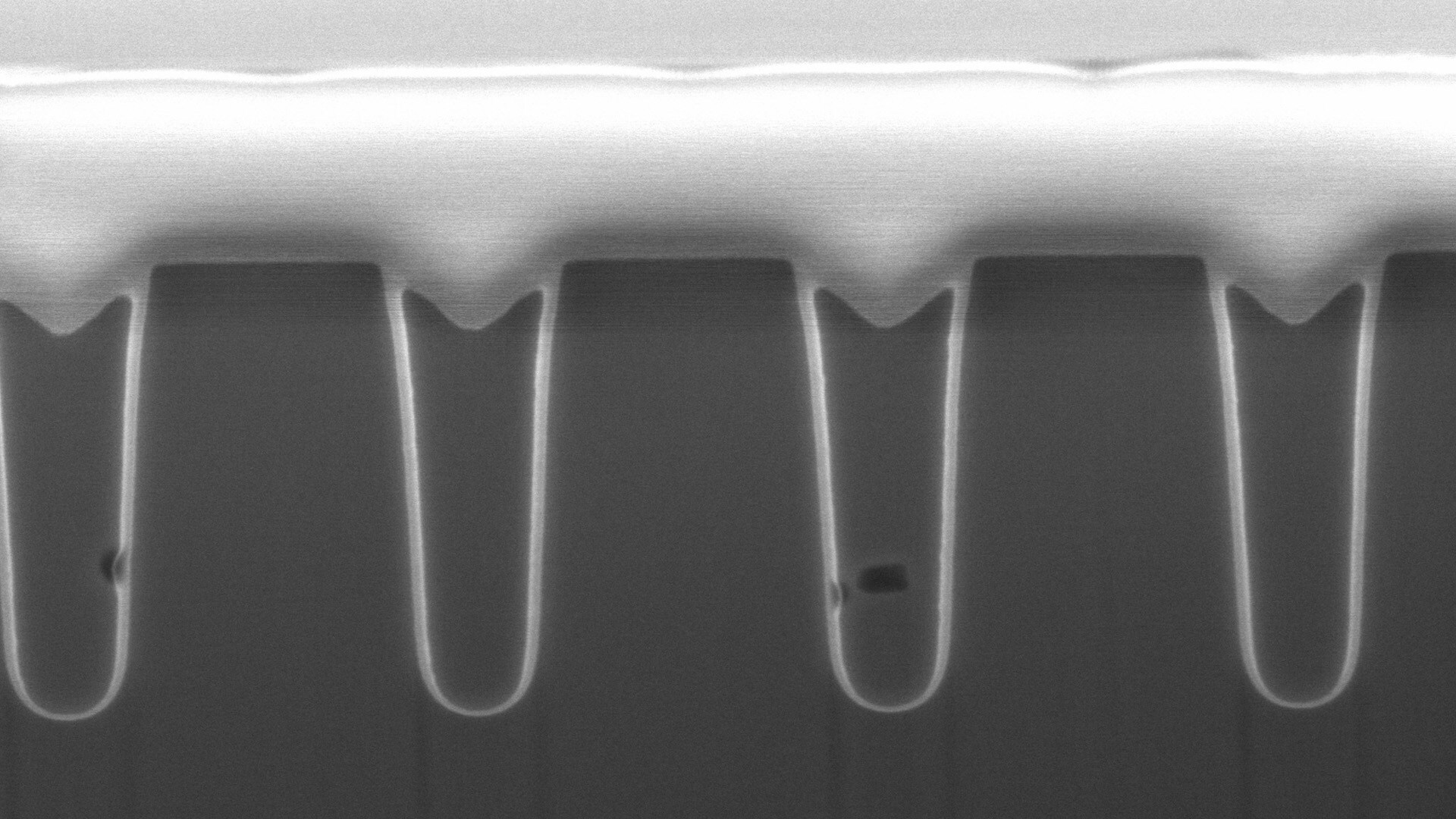
Semiconductor power devices
Novel architectures and materials pose new challenges. Learn how to pinpoint faults and characterize materials, structures, and interfaces.
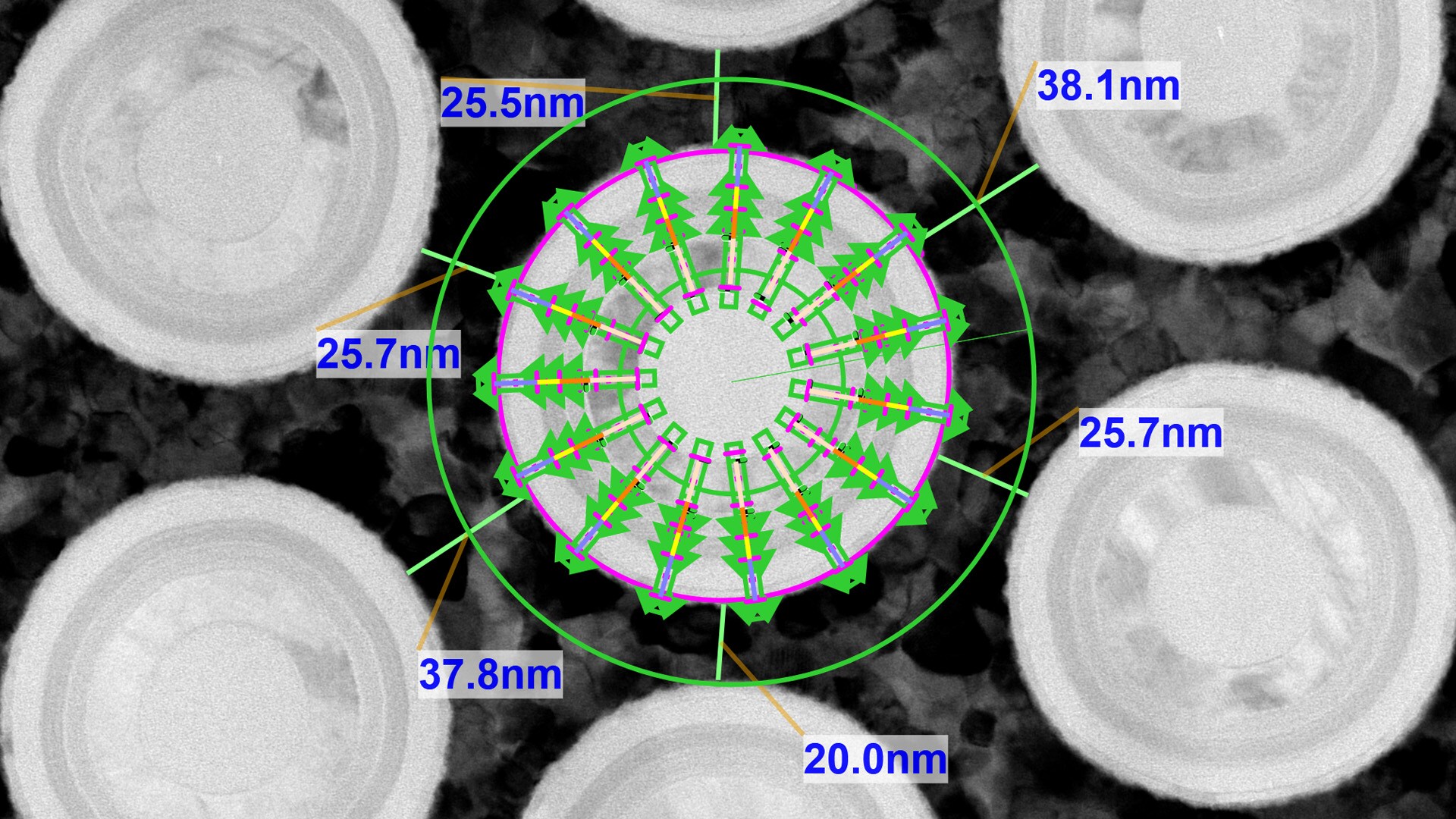
Semiconductor metrology
Manufacturing today’s complex semiconductors requires exact process controls. Learn more about advanced metrology and analysis solutions to accelerate yield learnings.
TEM Metrology
Advanced and automated TEM metrology routines deliver significantly greater precision than manual methods. This allows users to generate large amounts of statistically relevant data, with sub-angstrom-level specificity, that is free of operator bias.
Semiconductor TEM Imaging and Analysis
Thermo Scientific transmission electron microscopes offer high-resolution imaging and analysis of semiconductor devices, enabling manufacturers to calibrate toolsets, diagnose failure mechanisms, and optimize overall process yields.
Circuit Edit
Advanced, dedicated circuit edit and nanoprototyping solutions, which combine novel gas-delivery systems with a broad portfolio of chemistries and focused ion beam technology, offer unparalleled control and precision for semiconductor device development.
SEM Metrology
Scanning electron microscopy provides accurate and reliable metrology data at nanometer scales. Automated ultra-high-resolution SEM metrology enables faster time-to-yield and time-to-market for memory, logic, and data storage applications.
Semiconductor Analysis and Imaging
Thermo Fisher Scientific offers scanning electron microscopes for every function of a semiconductor lab, from general imaging tasks to advanced failure analysis techniques requiring precise voltage-contrast measurements.
Optical Fault Isolation
Increasingly complex designs complicate fault and defect isolation in semiconductor manufacturing. Optical fault isolation techniques allow you to analyze the performance of electrically active devices to locate critical defects that cause device failure.
Thermal Fault Isolation
Uneven distribution of local power dissipation can cause large, localized increases in temperature, leading to device failure. We offer unique solutions for thermal fault isolation with high-sensitivity lock-in infrared thermography (LIT).
Sample Preparation of Semiconductor Devices
Thermo Scientific DualBeam systems provide accurate TEM sample preparation for atomic-scale analysis of semiconductor devices. Automation and advanced machine learning technologies produce high-quality samples, at the correct location, and a low cost per sample.
Nanoprobing
As device complexity increases, so does the number of places defects have to hide. Nanoprobing provides the precise localization of electrical faults, which is critical for an effective transmission electron microscopy failure analysis workflow.
Semiconductor Laser Ablation
Laser ablation provides high-throughput milling of semiconductor devices for imaging and analysis with electron microscopy, while still preserving sample integrity. Access large-volume 3D data and optimize milling conditions to best suit your sample type.
Device Delayering
Shrinking feature size, along with advanced design and architecture, results in increasingly challenging failure analysis for semiconductors. Damage-free delayering of devices is a critical technique for the detection of buried electrical faults and failures.
ESD Compliance Testing
Electrostatic discharge (ESD) can damage small features and structures in semiconductors and integrated circuits. We offer a comprehensive suite of test equipment which verifies that your devices meet targeted ESD compliance standards.
TEM Metrology
Advanced and automated TEM metrology routines deliver significantly greater precision than manual methods. This allows users to generate large amounts of statistically relevant data, with sub-angstrom-level specificity, that is free of operator bias.
Semiconductor TEM Imaging and Analysis
Thermo Scientific transmission electron microscopes offer high-resolution imaging and analysis of semiconductor devices, enabling manufacturers to calibrate toolsets, diagnose failure mechanisms, and optimize overall process yields.
Circuit Edit
Advanced, dedicated circuit edit and nanoprototyping solutions, which combine novel gas-delivery systems with a broad portfolio of chemistries and focused ion beam technology, offer unparalleled control and precision for semiconductor device development.
SEM Metrology
Scanning electron microscopy provides accurate and reliable metrology data at nanometer scales. Automated ultra-high-resolution SEM metrology enables faster time-to-yield and time-to-market for memory, logic, and data storage applications.
Semiconductor Analysis and Imaging
Thermo Fisher Scientific offers scanning electron microscopes for every function of a semiconductor lab, from general imaging tasks to advanced failure analysis techniques requiring precise voltage-contrast measurements.
Optical Fault Isolation
Increasingly complex designs complicate fault and defect isolation in semiconductor manufacturing. Optical fault isolation techniques allow you to analyze the performance of electrically active devices to locate critical defects that cause device failure.
Thermal Fault Isolation
Uneven distribution of local power dissipation can cause large, localized increases in temperature, leading to device failure. We offer unique solutions for thermal fault isolation with high-sensitivity lock-in infrared thermography (LIT).
Sample Preparation of Semiconductor Devices
Thermo Scientific DualBeam systems provide accurate TEM sample preparation for atomic-scale analysis of semiconductor devices. Automation and advanced machine learning technologies produce high-quality samples, at the correct location, and a low cost per sample.
Nanoprobing
As device complexity increases, so does the number of places defects have to hide. Nanoprobing provides the precise localization of electrical faults, which is critical for an effective transmission electron microscopy failure analysis workflow.
Semiconductor Laser Ablation
Laser ablation provides high-throughput milling of semiconductor devices for imaging and analysis with electron microscopy, while still preserving sample integrity. Access large-volume 3D data and optimize milling conditions to best suit your sample type.
Device Delayering
Shrinking feature size, along with advanced design and architecture, results in increasingly challenging failure analysis for semiconductors. Damage-free delayering of devices is a critical technique for the detection of buried electrical faults and failures.
ESD Compliance Testing
Electrostatic discharge (ESD) can damage small features and structures in semiconductors and integrated circuits. We offer a comprehensive suite of test equipment which verifies that your devices meet targeted ESD compliance standards.






























