Search
Thermo Scientific Hyperion II 시스템은 반도체 기술 개발, 수율 엔지니어링, 장치 신뢰성 개선을 지원하기 위해 전기적 특성 분석 및 고장 위치 파악을 위한 빠르고 정확한 트랜지스터 프로빙을 제공합니다. Hyperion II 시스템의 탁월한 안정성으로 나노 프로빙(nanoprobing)을 5 nm 기술 노드 이상으로 수행할 수 있습니다.
Hyperion II 시스템의 SPM 기술은 PicoCurrent 이미징 기술을 지원합니다. 이 기술은 수동 전압 콘트라스트의 1,000 배 이상의 감도로 단락, 개방, 누출 경로, 저항성 접점을 빠르게 식별하는 기술입니다. 주사 커패시턴스 현미경 검사(SCM) 모듈은 silicon on insulator(SOI) 웨이퍼에 대한 이미지 기반 고장 위치 파악 기능 및 고분해능 도펀트 프로파일링을 제공합니다.
기능
| 측정 모드 Hyperion II 시스템의 첨단 측정 모드의 장점:
|
전류 전압(I-V) 측정
대상 영역 내에서 여러 개의 트랜지스터를 프로빙하면 고장 위치를 파악하는 데 시간이 오래 걸릴 수 있습니다. Hyperion II 시스템은 PicoCurrent 이미징과 I-V 프로빙을 결합하여 측정-관련 시프트의 도입 없이도 잠재적인 결함을 빠르게 찾고 전류 전압 곡선을 측정합니다.
커패시턴스 전압(C-V) 측정
C-V는 산화물 층, 인터페이스 트랩, 전하 캐리어 밀도를 연구하는 데 사용됩니다. Hyperion II 시스템은 탁월한 임피던스 제어, 낮은 누출, 매우 낮은 노이즈로 고분해능 C-V를 제공합니다.
신속한 고장 위치 파악
통합된 PicoCurrent Imaging 및 Scanning Capacitance Microscopy(SCM)는 나노 프로빙(nanoprobing)에 대해 고장 가능성이 큰 부분을 빠르게 식별합니다.
eFast 안내형 작업
생산성 향상, 사용 편의성, 교육 부담 감소를 위해 반자동 단계별 안내형 작업
ebeam-시료 상호작용 없음
SEM 이미징과 진공 시스템이 필요없는 원자간력(atomic force) 프로브 이미지 및 프로브 기능.
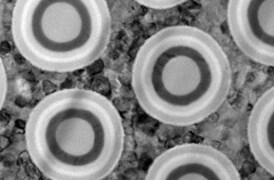
반도체 경로탐색(Pathfinding) 및 개발
고성능 반도체 장치의 제조에 필요한 실행 가능한 솔루션과 설계 방법을 확인하기 위한 고급 전자 현미경 검사, 집속 이온빔 및 관련 분석 기법.

반도체 불량 분석
반도체 장치 구조가 점점 복잡해짐에 따라 숨겨진 장애 유발 결함이 더 많아지고 있습니다. 당사의 차세대 워크플로우는 사용자가 수율, 성능, 신뢰성에 영향을 미치는 미세한 전기 문제를 로컬화하고 특성을 분석하는 데 도움을 줍니다.

물리적 및 화학적 특성 분석
지속적인 소비자 수요는 더 작고 빠르며 저렴한 전자 장치를 만들도록 촉진합니다. 그 생산은 광범위한 반도체 및 디스플레이 장치를 이미지화, 분석 및 특성 분석하는 고생산성 기기 및 워크플로우에 의존합니다.

ESD 반도체 적격성 검사
정전기 방출(ESD)에 민감한 소자를 식별하려면 모든 ESD 관리 계획이 필요합니다. 당사는 기기 적격성 요건을 충족할 수 있도록 완벽한 테스트 시스템 제품군을 제공합니다.
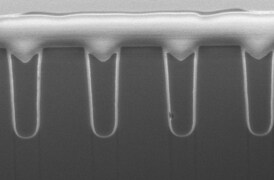
전력 반도체 장치 분석
전력 장치는 주로 전력 장치 아키텍쳐 및 레이아웃의 결과로서 오류를 국지화를 위한 고유한 과제를 제기합니다. 저희의 전력 장치 분석 도구와 워크플로우는 작동 조건에서 오류 위치를 빠르게 찾고 물질 특성 분석, 인터페이스, 장치 구조에 대한 정밀하고 고처리량의 분석을 제공합니다.
나노탐침
장치의 복잡성이 증가함에 따라 결함을 숨겨야 하는 부분의 수도 증가합니다. 나노탐침은 효과적인 투과 전자 현미경 불량 분석 워크플로우에서 중요한 전기 고장의 정확한 위치 측정 기능을 제공합니다.
나노탐침
장치의 복잡성이 증가함에 따라 결함을 숨겨야 하는 부분의 수도 증가합니다. 나노탐침은 효과적인 투과 전자 현미경 불량 분석 워크플로우에서 중요한 전기 고장의 정확한 위치 측정 기능을 제공합니다.



