Search

ELECTRICAL FAILURE ANALYSIS SYSTEMS
Meridian 4 System
Photon emission microscopy and laser scanning microscopy for electrical fault localization.
Join the Conversation
The ability to improve yield and reliability includes detailed defect analysis. Design debugging of marginal failures can be more challenging due to voltage or timing issues within the device. Determining the root cause of parametric failure requires isolation of its location at both the circuit level and the device level without damaging the device or obscuring the defects.
The Thermo Scientific Meridian 4 System is the preferred choice for developers of advanced, low-voltage, high-density semiconductor devices requiring performance and the ability to diagnose wide-ranging failure modes, including parametric failures and those resulting from design-process marginalities.
Advanced Thermo Scientific Sierra User Environment and Analysis Software includes the ability to construct high-quality, high-magnification image mosaics. Individual high-magnification images are acquired and then seamlessly integrated to form a high-resolution image of the device over a large field of view.
Photon emission microscopy for isolating FEOL issues
- Standard InGaAs or extended-wavelength DBX photon emission detection options for low-voltage devices and weak emission signatures requiring high sensitivity
- Low noise with unmatched signal-to-noise ratios for rapid, transistor-level fault detection
- Industry-leading results on sub-0.5 Vdd devices with the DBX configuration
Laser scanning microscopy for static and dynamic failure analysis
- High-resolution, high-contrast confocal laser scanning system
- Static Laser Stimulation (SLS) applications including OBIRCH, OBIC, and Seebeck Effect Imaging (SEI)
- Defect isolation and characterization under dynamic test conditions for advanced devices
- Soft defect localization (SDL), laser voltage imaging (LVI), and laser voltage probing (LVP) dynamic techniques enable localization of parametric failures, debug design and timing issues, and map transistor frequencies
- Optional Time-resolved LADA for critical timing analysis

TR-LADA for Dynamic OFI
Preserving sensitive circuit areas while delivering greater defect localization capabilities is what the new TR-LADA option can do for your Meridian Optical Fault Isolation system.

TR-LADA for Dynamic OFI
Preserving sensitive circuit areas while delivering greater defect localization capabilities is what the new TR-LADA option can do for your Meridian Optical Fault Isolation system.
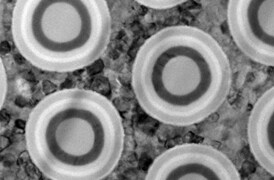
Desenvolvimento e localização de semicondutores
Microscopia eletrônica avançada, feixe de íon focalizado e técnicas analíticas associadas para identificar soluções viáveis e métodos de desenho para a fabricação de dispositivos semicondutores de alto desempenho.

Análise de falha de semicondutores
Estruturas de dispositivos semicondutores cada vez mais complexas resultam em mais locais onde defeitos que induzem falhas podem se ocultar. Nossos fluxos de trabalho de última geração o ajudam a localizar e caracterizar problemas elétricos sutis que afetam o rendimento, o desempenho e a confiabilidade.
Isolamento de falha óptica
Projetos cada vez mais complexos dificultam o isolamento de falhas e defeitos na fabricação de semicondutores. As técnicas de isolamento óptico de falhas permitem analisar o desempenho de dispositivos eletricamente ativos para localizar defeitos críticos que causam falhas no dispositivo.
Isolamento de falha óptica
Projetos cada vez mais complexos dificultam o isolamento de falhas e defeitos na fabricação de semicondutores. As técnicas de isolamento óptico de falhas permitem analisar o desempenho de dispositivos eletricamente ativos para localizar defeitos críticos que causam falhas no dispositivo.
Serviços de microscopia eletrônica para
semicondutores
Para garantir o desempenho ideal do sistema, fornecemos acesso a uma rede de especialistas em serviços de campo, suporte técnico e peças de reposição certificadas.