Search
Semiconductor Analysis
Semiconductor Scanning Electron Microscope Analysis and Imaging
Semiconductor imaging and analysis solutions with scanning electron microscopy, supporting a wide variety of advanced failure analysis applications.
Join the Conversation
The miniaturization of semiconductor devices is continuing at an extraordinary rate. In order to accurately develop, characterize, and test these devices, advanced imaging and analysis techniques are needed. From simple, general tasks to advanced failure analysis (FA) techniques that need extremely precise voltage-contrast measurements on complex devices, scanning electron microscopy (SEM) imaging can provide you with a large variety of critical data for your semiconductor manufacturing needs.
For example, higher accelerating voltages are often used to maximize signal and reduce time-to-data. These higher voltages were once acceptable because of the larger structural dimensions found in previous generation devices. However, as feature sizes continue to shrink due to device miniaturization, higher accelerating voltages are no longer appropriate, and lower voltages are necessary to accurately image smaller features. Low kV imaging also allows you to analyze working transistors without impacting their characteristics and helps you resolve layers without interference from the underlying sections. New materials also require low voltage to minimize beam damage.
Thermo Fisher Scientific offers a range of SEM instrumentation, including low-voltage tools ideally suited to analyze the next generation of semiconductor devices. This includes the versatile Thermo Scientific Quattro SEM, our general-purpose tool available with Thermo Scientific ChemiSEM Technology. We also offer high-quality, and low-kV imaging on the Thermo Scientific Apreo SEM, and high-contrast sub-nanometer imaging on the Thermo Scientific Verios XHR SEM. Please click through to the appropriate product pages below for more information.

Semiconductor Advanced Packaging
Performance, power efficiency, area, and cost are driving packaging innovations. Learn how workflows provide fast, precise, and accurate time-to-data.

Semiconductor research and development
Innovation starts with research and development. Learn more about solutions to help you understand innovative structures and materials at the atomic level.
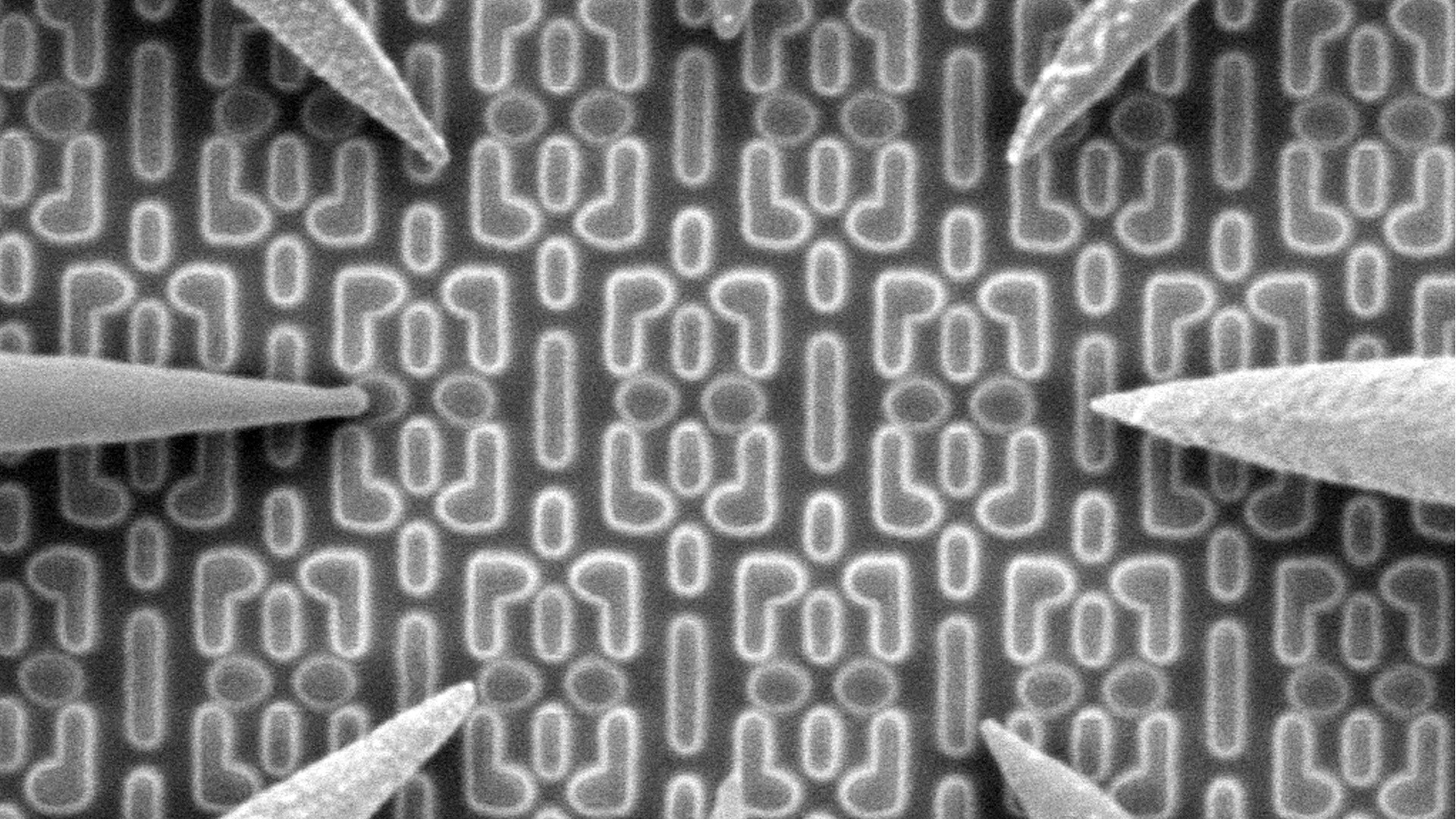
Semiconductor Failure Analysis
Complex semiconductor device structures result in more places for defects to hide. Learn more about failure analysis solutions to isolate, analyze, and repair defects.

Semiconductor materials characterization
Many factors impact yield, performance, and reliability. Learn more about solutions to characterize physical, structural, and chemical properties.
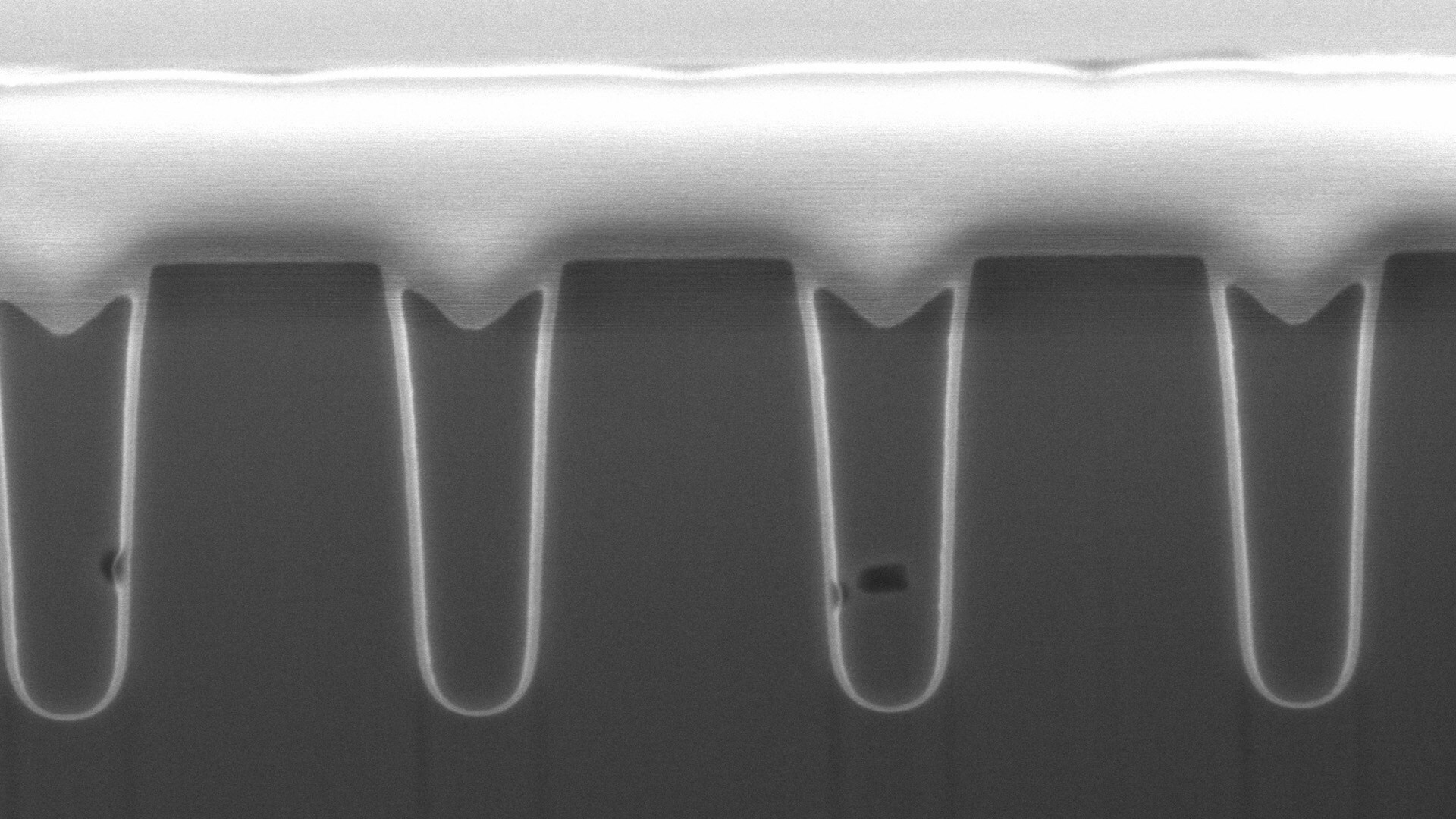
Semiconductor power devices
Novel architectures and materials pose new challenges. Learn how to pinpoint faults and characterize materials, structures, and interfaces.

Semiconductor display technology
Display technologies are evolving to improve display quality and light conversion efficiency. Learn how metrology, failure analysis, and characterization solutions provide insights.
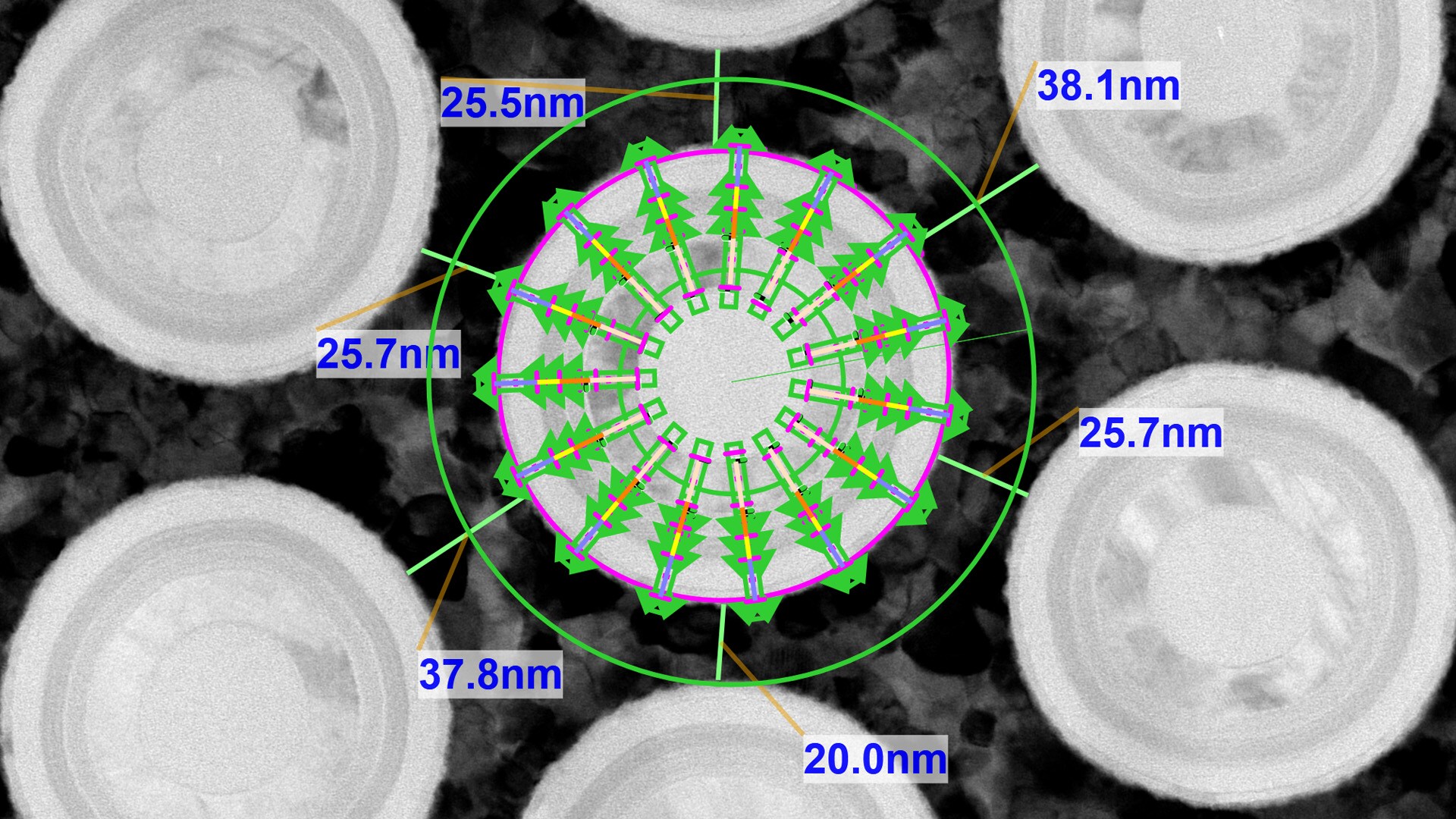
Semiconductor metrology
Manufacturing today’s complex semiconductors requires exact process controls. Learn more about advanced metrology and analysis solutions to accelerate yield learnings.
Semiconductor Materials and Device Characterization
As semiconductor devices shrink and become more complex, new designs and structures are needed. High-productivity 3D analysis workflows can shorten device development time, maximize yield, and ensure that devices meet the future needs of the industry.











