Search
Semiconductor Analysis
Thermal Fault Isolation
Lock in thermography (LIT) for accurately locating thermal failures in semiconductor device design.
Join the Conversation
Semiconductor devices can fail for many reasons, leading to wasted time and increased costs for the manufacturer. Failures can result from excess current or voltage, ionizing radiation, mechanical stress, or large increases in temperature, which are the consequence of an uneven distribution of local power dissipation.
Steady-state and lock-in thermography are techniques that allow you to detect the temperature variations that lead to device failures. Of these methods, lock-in infrared (IR) thermography (LIT) offers much better signal-to-noise ratio, sensitivity, and feature resolution than steady-state thermography. LIT can be used in the failure analysis of semiconductor interconnects to locate line shorts, electrostatic discharge (ESD) defects, oxide damage, defective transistors and diodes, and device latch-ups.
LIT is an increasingly valuable technique for locating thermal faults in a broad range of semiconductor devices. The Thermo Scientific ELITE System is a powerful LIT tool that is particularly useful when combined with the Thermo Scientific Helios PFIB DualBeam for physical analysis, creating a highly efficient workflow. Learn more by exploring the product pages below.

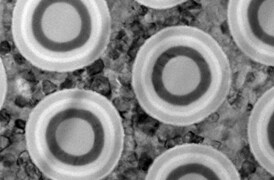
Desarrollo y trazabilidad de semiconductores
Microscopía electrónica avanzada, haz de iones enfocado y técnicas analíticas asociadas para identificar soluciones viables y métodos de diseño para la fabricación de dispositivos semiconductores de alto rendimiento.

Análisis de fallos de semiconductores
Las estructuras de dispositivos semiconductores cada vez más complejas dan lugar a que existan más ubicaciones en las que se oculten los defectos inducidos por fallos. Nuestros flujos de trabajo de última generación le ayudarán a localizar y caracterizar los sutiles problemas eléctricos que afectan a la producción, al rendimiento y a la fiabilidad.

Caracterización física y química
La demanda continua de los consumidores impulsa la creación de dispositivos electrónicos más pequeños, más rápidos y más baratos. Su producción se basa en instrumentos y flujos de trabajo de alta productividad que generan imágenes, analizan y caracterizan una amplia gama de semiconductores y dispositivos de visualización.

Cualificación de semiconductor ESD
Se necesita un plan de control de descarga electrostática (ESD) para identificar los dispositivos que son sensibles a ESD. Ofrecemos un conjunto completo de sistemas de prueba para ayudarle con los requisitos de cualificación de su dispositivo.

Metrología y rampa de producción
Ofrecemos capacidades analíticas avanzadas para el análisis de defectos, metrología y control de procesos, diseñadas para ayudar a aumentar la productividad y mejorar el rendimiento en una amplia gama de aplicaciones y dispositivos semiconductores.
Materiales semiconductores y caracterización de dispositivos
A medida que los dispositivos semiconductores se reducen y se vuelven más complejos, se necesitan nuevos diseños y estructuras. Los flujos de trabajo de análisis en 3D de alta productividad pueden reducir el tiempo de desarrollo de dispositivos, maximizar el rendimiento y garantizar que los dispositivos satisfacen las necesidades futuras del sector.







