Search

DualBeam Microscopes
Helios 5 PXL PFIB Wafer DualBeam
PFIB SEM for in-line metrology and process monitoring of advanced 3D NAND and DRAM devices.
The Thermo Scientific Helios 5 PXL Wafer DualBeam is a plasma focused ion beam scanning electron microscope (PFIB SEM) that redefines the standard for high-aspect-ratio through-stack metrology and structural verification. It features high-performance in-line metrology and process monitoring to quickly provide critical insights for process development and manufacturing engineers.
Designed to meet the in-line metrology and process control requirements of the fab, the Helios 5 PXL Wafer DualBeam significantly reduces time to data and enables the wafer to be returned to the line without being pulled and scrapped.
The Helios 5 PXL Wafer DualBeam is compatible with semiconductor factory automation, facilitating operator-free recipe-driven operations. This automation can support the high-throughput requirements of fab metrology and process monitoring – even on the most challenging structures.
Fast time to data
Utilizing the patented Thermo Scientific Elstar Electron Column with the high-performance PFIB2.0 xenon plasma ion column, the Helios 5 PXL Wafer DualBeam delivers high-resolution, high-contrast imaging. Obtain exact dimensional measurements of high-aspect-ratio 3D through-stack structures, data that is not easily accessible to conventional in-line metrology tools.
Faster yield learning and increased productivity
Fast, precise, large-area wafer level deprocessing, diagonal milling and cross sectioning of high-aspect-ratio structures. Advanced automation capabilities identify potential issues, accelerating process development and minimizing manufacturing disruptions.
World-class service, knowledge, and expertise
The Helios 5 PXL Wafer DualBeam is backed by our world-class service, knowledge, and expertise in advanced metrology sample preparation and failure analysis.
| Xe+ Plasma FIB Column |
|
| Elstar UHR Immersion Lens FESEM Column |
|
| Gas delivery |
|
| Wafer handling |
|
| Additional options |
|
The Thermo Scientific Helios DualBeam Family
The Thermo Scientific Helios DualBeam Family
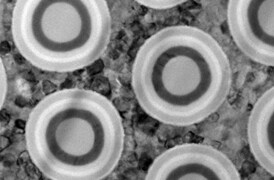
Desarrollo y trazabilidad de semiconductores
Microscopía electrónica avanzada, haz de iones enfocado y técnicas analíticas asociadas para identificar soluciones viables y métodos de diseño para la fabricación de dispositivos semiconductores de alto rendimiento.

Metrología y rampa de producción
Ofrecemos capacidades analíticas avanzadas para el análisis de defectos, metrología y control de procesos, diseñadas para ayudar a aumentar la productividad y mejorar el rendimiento en una amplia gama de aplicaciones y dispositivos semiconductores.

Análisis de fallos de semiconductores
Las estructuras de dispositivos semiconductores cada vez más complejas dan lugar a que existan más ubicaciones en las que se oculten los defectos inducidos por fallos. Nuestros flujos de trabajo de última generación le ayudarán a localizar y caracterizar los sutiles problemas eléctricos que afectan a la producción, al rendimiento y a la fiabilidad.

Cualificación de semiconductor ESD
Se necesita un plan de control de descarga electrostática (ESD) para identificar los dispositivos que son sensibles a ESD. Ofrecemos un conjunto completo de sistemas de prueba para ayudarle con los requisitos de cualificación de su dispositivo.

Caracterización física y química
La demanda continua de los consumidores impulsa la creación de dispositivos electrónicos más pequeños, más rápidos y más baratos. Su producción se basa en instrumentos y flujos de trabajo de alta productividad que generan imágenes, analizan y caracterizan una amplia gama de semiconductores y dispositivos de visualización.
Nanosondeo
A medida que aumenta la complejidad del dispositivo, también lo hace el número de ubicaciones que tienen que ocultar los defectos. El nanosondeo proporciona la ubicación precisa de fallos eléctricos, lo que es fundamental para un flujo de trabajo de análisis de fallos de microscopía electrónica de transmisión eficaz.
Aislamiento de fallo óptico
Los diseños cada vez más complejos complican el aislamiento de fallos y defectos en la fabricación de semiconductores. Las técnicas de aislamiento óptico de fallos le permiten analizar el rendimiento de los dispositivos activos eléctricamente para localizar defectos críticos que causan fallos en el dispositivo.
Aislamiento de fallo térmico
La distribución desigual de la disipación de energía local puede causar aumentos de temperatura importantes y localizados, lo que provoca un fallo del dispositivo. Ofrecemos soluciones únicas para el aislamiento de fallos térmicos con termografía infrarroja de alta sensibilidad (LIT).
Adquisición de imágenes y análisis TEM de semiconductores
Los microscopios de electrones de transmisión de Thermo Fisher Scientific ofrecen imágenes y análisis de alta resolución de dispositivos semiconductores, lo que permite a los fabricantes calibrar conjuntos de herramientas, diagnosticar mecanismos de fallos y optimizar la producción rendimiento general del proceso.
Metrología de TEM
Las rutinas de metrología TEM avanzadas y automatizadas ofrecen una precisión significativamente mayor que los métodos manuales. Esto permite a los usuarios generar grandes cantidades de datos estadísticamente relevantes, con una especificidad de nivel subangstrom, sin fallos del operador.
Preparación de muestras de dispositivos semiconductores
Los sistemas DualBeam de Thermo Scientific proporcionan una preparación precisa de las muestras de TEM para el análisis a escala atómica de dispositivos semiconductores. La automatización y las tecnologías de aprendizaje automático avanzado producen muestras de alta calidad, en la ubicación correcta y con un bajo costo por muestra.
Metrología de SEM
La microscopía electrónica de barrido proporciona datos de metrología precisos y fiables a escala nanométrica. La metrología SEM automatizada de resolución ultraalta permite un tiempo de producción y un de comercialización más rápidos para aplicaciones de memoria, lógica y almacenamiento de datos.
Adquisición de imágenes y análisis de semiconductores
Thermo Fisher Scientific ofrece microscopios electrónicos de barrido para todas las funciones de un laboratorio de semiconductores, desde tareas generales de adquisición de imágenes hasta técnicas avanzadas de análisis de fallos que requieren mediciones precisas de contraste de tensión.
Reestructuración de dispositivo
La contracción del tamaño de las características, junto con los resultados de diseño y arquitectura avanzados provocan fallos cada vez más complicados para los semiconductores. La reestructuración sin daños de los dispositivos es una técnica crucial para la detección de errores y fallos eléctricos interiores.
Pruebas de conformidad con ESD
La descarga electrostática (ESD) puede dañar pequeñas características y estructuras en semiconductores y circuitos integrados. Ofrecemos un completo conjunto de equipos de prueba que verifica que sus dispositivos cumplen con los estándares de conformidad ESD.
Nanosondeo
A medida que aumenta la complejidad del dispositivo, también lo hace el número de ubicaciones que tienen que ocultar los defectos. El nanosondeo proporciona la ubicación precisa de fallos eléctricos, lo que es fundamental para un flujo de trabajo de análisis de fallos de microscopía electrónica de transmisión eficaz.
Aislamiento de fallo óptico
Los diseños cada vez más complejos complican el aislamiento de fallos y defectos en la fabricación de semiconductores. Las técnicas de aislamiento óptico de fallos le permiten analizar el rendimiento de los dispositivos activos eléctricamente para localizar defectos críticos que causan fallos en el dispositivo.
Aislamiento de fallo térmico
La distribución desigual de la disipación de energía local puede causar aumentos de temperatura importantes y localizados, lo que provoca un fallo del dispositivo. Ofrecemos soluciones únicas para el aislamiento de fallos térmicos con termografía infrarroja de alta sensibilidad (LIT).
Adquisición de imágenes y análisis TEM de semiconductores
Los microscopios de electrones de transmisión de Thermo Fisher Scientific ofrecen imágenes y análisis de alta resolución de dispositivos semiconductores, lo que permite a los fabricantes calibrar conjuntos de herramientas, diagnosticar mecanismos de fallos y optimizar la producción rendimiento general del proceso.
Metrología de TEM
Las rutinas de metrología TEM avanzadas y automatizadas ofrecen una precisión significativamente mayor que los métodos manuales. Esto permite a los usuarios generar grandes cantidades de datos estadísticamente relevantes, con una especificidad de nivel subangstrom, sin fallos del operador.
Preparación de muestras de dispositivos semiconductores
Los sistemas DualBeam de Thermo Scientific proporcionan una preparación precisa de las muestras de TEM para el análisis a escala atómica de dispositivos semiconductores. La automatización y las tecnologías de aprendizaje automático avanzado producen muestras de alta calidad, en la ubicación correcta y con un bajo costo por muestra.
Metrología de SEM
La microscopía electrónica de barrido proporciona datos de metrología precisos y fiables a escala nanométrica. La metrología SEM automatizada de resolución ultraalta permite un tiempo de producción y un de comercialización más rápidos para aplicaciones de memoria, lógica y almacenamiento de datos.
Adquisición de imágenes y análisis de semiconductores
Thermo Fisher Scientific ofrece microscopios electrónicos de barrido para todas las funciones de un laboratorio de semiconductores, desde tareas generales de adquisición de imágenes hasta técnicas avanzadas de análisis de fallos que requieren mediciones precisas de contraste de tensión.
Reestructuración de dispositivo
La contracción del tamaño de las características, junto con los resultados de diseño y arquitectura avanzados provocan fallos cada vez más complicados para los semiconductores. La reestructuración sin daños de los dispositivos es una técnica crucial para la detección de errores y fallos eléctricos interiores.
Pruebas de conformidad con ESD
La descarga electrostática (ESD) puede dañar pequeñas características y estructuras en semiconductores y circuitos integrados. Ofrecemos un completo conjunto de equipos de prueba que verifica que sus dispositivos cumplen con los estándares de conformidad ESD.
Servicios de microscopía electrónica para
Semiconductores
Para garantizar un rendimiento óptimo del sistema, le proporcionamos acceso a una red de expertos de primer nivel en servicios de campo, asistencia técnica y piezas de repuesto certificadas.