Search
The Thermo Scientific Hyperion II System offers fast, accurate transistor probing for electrical characterization and fault localization in support of semiconductor technology development, yield engineering and device reliability improvement. The unparalleled stability of the Hyperion II System enables nanoprobing down to the 5 nm technology node and beyond.
The Hyperion II System’s SPM technology enables PicoCurrent imaging, which is a technique to rapidly identify shorts, opens, leakage paths and resistive contacts with more than 1,000 times the sensitivity of passive voltage contrast. The scanning capacitance microscopy (SCM) module provides image-based fault localization for silicon on insulator (SOI) wafers, as well as high-resolution dopant profiling.
Capabilities
| Measurement modes The Hyperion II System’s advanced measurement modes include:
|
Current voltage (I-V) measurements
Probing multiple transistors within the target area to localize a fault can be time-consuming. The Hyperion II System combines PicoCurrent imaging with I-V probing to quickly find potential defects and measure current-voltage curves, without introducing measurement-related shifts.
Capacitance voltage (C-V) measurements
C-V is used to study oxide layers, interface traps and charge carrier densities. The Hyperion II System offers high-resolution C-V with excellent impedance control, low leakage and very low noise.
Pulsed I-V measurements
Pulsed I-V is used for studying self-heating of SOI and trapped charge in high-k dielectric. The Hyperion II System enables high-speed testing of devices with less than 2 nanosecond rise time.
Fast fault localization
Integrated PicoCurrent Imaging and Scanning Capacitance Microscopy (SCM) quickly identifies fault candidates for nanoprobing.
eFast guided operation
Semi-automated step by step guided operation for increased productivity, ease of use and reduced training burden.
No ebeam-sample interaction
Atomic force probes image and probe features, eliminating need for SEM imaging and vacuum system.
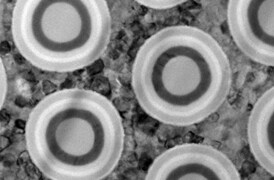
Desarrollo y trazabilidad de semiconductores
Microscopía electrónica avanzada, haz de iones enfocado y técnicas analíticas asociadas para identificar soluciones viables y métodos de diseño para la fabricación de dispositivos semiconductores de alto rendimiento.

Análisis de fallos de semiconductores
Las estructuras de dispositivos semiconductores cada vez más complejas dan lugar a que existan más ubicaciones en las que se oculten los defectos inducidos por fallos. Nuestros flujos de trabajo de última generación le ayudarán a localizar y caracterizar los sutiles problemas eléctricos que afectan a la producción, al rendimiento y a la fiabilidad.

Cualificación de semiconductor ESD
Se necesita un plan de control de descarga electrostática (ESD) para identificar los dispositivos que son sensibles a ESD. Ofrecemos un conjunto completo de sistemas de prueba para ayudarle con los requisitos de cualificación de su dispositivo.

Caracterización física y química
La demanda continua de los consumidores impulsa la creación de dispositivos electrónicos más pequeños, más rápidos y más baratos. Su producción se basa en instrumentos y flujos de trabajo de alta productividad que generan imágenes, analizan y caracterizan una amplia gama de semiconductores y dispositivos de visualización.
Nanosondeo
A medida que aumenta la complejidad del dispositivo, también lo hace el número de ubicaciones que tienen que ocultar los defectos. El nanosondeo proporciona la ubicación precisa de fallos eléctricos, lo que es fundamental para un flujo de trabajo de análisis de fallos de microscopía electrónica de transmisión eficaz.
Nanosondeo
A medida que aumenta la complejidad del dispositivo, también lo hace el número de ubicaciones que tienen que ocultar los defectos. El nanosondeo proporciona la ubicación precisa de fallos eléctricos, lo que es fundamental para un flujo de trabajo de análisis de fallos de microscopía electrónica de transmisión eficaz.
Servicios de microscopía electrónica para
Semiconductores
Para garantizar un rendimiento óptimo del sistema, le proporcionamos acceso a una red de expertos de primer nivel en servicios de campo, asistencia técnica y piezas de repuesto certificadas.



