Search

DualBeam Microscopes
Helios 5 PFIB DualBeam
Plasma focused ion beam scanning electron microscope for TEM sample preparation including 3D characterization, cross-sectioning and micromachining.
Join the Conversation
Plasma focused ion beam instrument
Helios 5 Plasma FIB DualBeam FiB SEM Microscope
The Thermo Scientific Helios 5 Plasma FIB (PFIB) DualBeam (focused ion beam scanning electron microscope, or FIB-SEM) delivers unmatched capabilities for materials science and semiconductor applications. For materials science researchers, the Helios 5 PFIB DualBeam provides large-volume 3D characterization, gallium-free sample preparation, and precise micromachining. For manufacturers of semiconductor devices, advanced packaging technology, and display devices, the Helios 5 PFIB DualBeam delivers damage-free, large-area de-processing, fast sample preparation, and high-fidelity failure analysis.
Gallium-free STEM and TEM sample preparation
High-quality, gallium-free TEM and APT sample preparation thanks to the new PFIB column enabling 500 V Xe+ final polishing and delivering superior performance at all operating conditions.
Advanced automation
Fastest and easiest, automated, multisite in situ and ex situ TEM sample preparation and cross-sectioning using optional AutoTEM 5 Software.
Next-generation 2.5 μA xenon plasma FIB column
High throughput and quality statistically relevant 3D characterization, cross-sectioning and micromachining using next generation 2.5 μA Xenon Plasma FIB column (PFIB).
Multi-modal subsurface and 3D information
Access high-quality, multi-modal subsurface and 3D information with precise targeting of the region of interest using optional Auto Slice & View 4 (AS&V4) Software.
Sub-nanometer performance at low energies
Reveal the finest details using best-in-class Elstar Electron Column with high-current UC+ monochromator technology, enabling sub-nanometer performance at low energies.
Complete sample information
The most complete sample information with sharp, refined, and charge-free contrast obtained from up to six integrated in-column and below-the-lens detectors.
Advanced capabilities
Most advanced capabilities for electron and ion beam induced deposition and etching on FIB/SEM systems with optional Thermo Scientific MultiChem or GIS Gas Delivery Systems.
Artifact-free imaging
Artifact-free imaging based on integrated sample cleanliness management and dedicated imaging modes such as SmartScan™ and DCFI Modes.
Short time to nanoscale information
Shortest time to nanoscale information for users with any experience level with SmartAlign and FLASH technologies.
Precise sample navigation
Precise sample navigation tailored to individual application needs thanks to the high stability and accuracy of 150 mm Piezo stage and optional in-chamber Nav-Cam.
Semiconductor device deprocessing
The combination of Dx chemistry and the plasma FIB beam provides a unique, site-specific, deprocessing and failure analysis workflow for advanced logic, 3D NAND, and DRAM.
High-speed, large-area cross-sectioning
The next-generation 2.5 μA xenon PFIB column provides high-throughput, high-quality, statistically relevant 3D characterization, cross-sectioning, and micromachining.
TEM sample preparation
Perform high-quality, single layer planar and cross-sectional, top-down, and inverted TEM sample preparation by combining PFIB deprocessing and Thermo Scientific guided workflows.
Sub-nanometer, low-energy SEM performance
Reveal the finest details using the best-in-class Elstar Electron Column with high-current UC+ monochromator technology, enabling sub-nanometer performance at low energies.
Advanced automation
Carry out automated deprocessing with end pointing. SmartAlign and FLASH technologies make for a short time to nanoscale information for users with any experience level.
Complete sample information
Obtain the most complete sample information with sharp, refined, and charge-free contrast from up to six integrated in-column and below-the-lens detectors.
Artifact-free imaging
Obtain artifact-free imaging with in situ auto rocking polish and dedicated imaging modes such as SmartScan and DCFI modes.
Precise sample navigation
Experience precise sample navigation tailored to individual application needs from the flexible 5-axis motorized stage configuration and ultra-high-resolution stage options.
| Helios 5 PFIB CXe DualBeam | Helios 5 PFIB UXe DualBeam | |
| Electron optics |
| |
| Electron beam resolution |
| |
| Electron beam parameter space |
| |
| Ion optics |
| |
| Detectors |
| |
| Stage and sample | Flexible 5-axis motorized stage:
| High-precision, 5-axis motorized stage with XYR axis, piezo-driven
|
*Available as an option, configuration dependent
| Helios 5 PFIB CXe DualBeam | Helios 5 PFIB UXe DualBeam | Helios 5 PFIB HXe DualBeam | |
| Application | Advanced packaging and display R&D and failure analysis | Advanced memory failure analysis | Advanced logic failure analysis |
| Electron optics |
| ||
| Electron beam resolution |
| ||
| Ion optics |
| ||
| Stage and sample | Flexible 5-axis motorized stage:
| High-precision, 5-axis motorized stage with XYR axis, piezo-driven
| 5-axis, all-Piezo-driven UHR stage
|

Partnering in sustainability — ACT label
Understand your lab's environmental impact with the Helios 5 PFIB’s ACT label. Created by My Green Lab, the ACT label sets the standard for determining the environmental impact of laboratory products and helps labs make informed, sustainable purchasing decisions.



Thermo Fisher Scientific PFA Demo Days
To support semiconductor manufacturing needs, Thermo Fisher Scientific continues to bring new capabilities to our industry-leading failure analysis, metrology and characterization solutions.
In our Thermo Fisher Scientific PFA Demo Days, we showcase our latest innovations for sample preparation and FinFET logic circuit delayering.
Advanced DualBeam automation for every need
Register for our exclusive webinar to learn how easy it has become to automate daily routine tasks on your DualBeam instrument using our Python-based AutoScript 4 API. Automation can also increase throughput, reproducibility and ease of use, quicken time to data and boost efficiency.
The Thermo Scientific Helios DualBeam
Interview - Laser PFIB use case from Manchester University
Interview - Laser PFIB use case from ScopeM



Thermo Fisher Scientific PFA Demo Days
To support semiconductor manufacturing needs, Thermo Fisher Scientific continues to bring new capabilities to our industry-leading failure analysis, metrology and characterization solutions.
In our Thermo Fisher Scientific PFA Demo Days, we showcase our latest innovations for sample preparation and FinFET logic circuit delayering.
Advanced DualBeam automation for every need
Register for our exclusive webinar to learn how easy it has become to automate daily routine tasks on your DualBeam instrument using our Python-based AutoScript 4 API. Automation can also increase throughput, reproducibility and ease of use, quicken time to data and boost efficiency.
The Thermo Scientific Helios DualBeam
Interview - Laser PFIB use case from Manchester University
Interview - Laser PFIB use case from ScopeM

Grundlagenforschung in der Materialforschung
Neuartige Materialien werden in immer kleineren Dimensionen untersucht, um ihre physikalischen und chemischen Eigenschaften bestmöglich zu kontrollieren. Die Elektronenmikroskopie gibt Forschern wichtige Einblicke in eine Vielzahl von Materialeigenschaften auf der Mikro- bis Nanoebene.
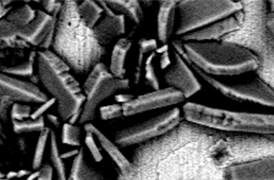
Prozesskontrolle mittels Elektronenmikroskopie
Die moderne Industrie verlangt einen hohen Durchsatz bei erstklassiger Qualität. Diese Balance wird durch eine robuste Prozesskontrolle aufrechterhalten. REM- und TEM-Geräte mit spezieller Automatisierungssoftware bieten schnelle, mehrskalige Informationen für die Überwachung und Verbesserung von Prozessen.

Qualitätskontrolle und Fehleranalyse
Qualitätskontrolle und Qualitätssicherung sind in der modernen Industrie von entscheidender Bedeutung. Wir bieten eine Reihe von EM- und Spektroskopiegeräten für die mehrskalige und multimodale Analyse von Mängeln, mit denen Sie zuverlässige und fundierte Entscheidungen für die Kontrolle und Verbesserung von Prozessen treffen können.

Fehleranalyse von Halbleitern
Durch immer komplexere Strukturen von Halbleiterbauelementen können sich an mehr Stellen folgenschwere Mängel verbergen. Mit unseren Arbeitsabläufen der nächsten Generation können Sie auch kleinste Probleme in der Elektrik lokalisieren und charakterisieren, die sich auf die Ausbeute, Leistung und Zuverlässigkeit auswirken.

Physikalische und chemische Charakterisierung
Die kontinuierliche Nachfrage der Verbraucher treibt die Entwicklung kleinerer, schnellerer und kostengünstigerer elektronischer Geräte voran. Ihre Fertigung basiert auf hoch produktiven Geräten und Arbeitsabläufen, die eine breite Palette von Halbleiterbauelementen und Anzeigegeräten abbilden, analysieren und charakterisieren.

Analyse von Leistungshalbleitern
Leistungshalbleiter stellen besondere Herausforderungen für die Lokalisierung von Fehlern dar, vor allem aufgrund der Architektur und des Aufbaus von Leistungshalbleitern. Unsere Geräte und Arbeitsabläufe für die Analyse von Leistungshalbleitern ermöglichen unter Betriebsbedingungen eine schnelle Bestimmung des Fehlerorts sowie eine präzise Hochdurchsatzanalyse zur Charakterisierung von Materialien, Schnittstellen und Bauelementstrukturen.

Pathfinding und Entwicklung von Halbleitern
Fortschrittliche Elektronenmikroskopie, fokussierter Ionenstrahl und zugehörige Analyseverfahren zur Identifizierung umsetzbarer Lösungen und Designmethoden für die Herstellung von leistungsstarken Halbleiterbauelementen.

Fehleranalyse von Anzeigemodulen
Die Entwicklung von Anzeigetechnologien zielt darauf ab, die Anzeigequalität und die Effizienz der Lichtkonvertierung zu verbessern, um Anwendungen in verschiedenen Branchen zu unterstützen und gleichzeitig die Produktionskosten weiter zu senken. Unsere Lösungen für Prozessmesstechnik, Fehleranalyse und Forschung und Entwicklung helfen Unternehmen, die sich mit Anzeigen beschäftigen, diese Herausforderungen zu meistern.

(S)TEM-Probenvorbereitung
DualBeam-Mikroskope ermöglichen die Vorbereitung hochwertiger, ultradünner Proben für die (S)TEM-Analyse. Dank fortschrittlicher Automatisierung können Anwender jeder Erfahrungsstufe für eine Vielzahl von Materialien Ergebnisse auf Expertenebene erzielen.

APT-Probenvorbereitung
Die Atomsondentomographie (Atom Probe Tomography, APT) ermöglicht die 3D-Kompositionsanalyse von Materialien mit atomarer Auflösung. Die Mikroskopie mit fokussiertem Ionenstrahl (Focused Ion Beam, FIB) ist eine äußerst wichtige Technologie für eine qualitativ hochwertige, ausrichtungs- und ortsspezifische Probenpräparation für die APT-Charakterisierung.

In-situ-Experimente
Die direkte Echtzeitbeobachtung mikrostruktureller Veränderungen mit der Elektronenmikroskopie ist notwendig, um die Grundprinzipien dynamischer Prozesse wie Rekristallisation, Kornwachstum und Phasenumwandlung während der Erwärmung, Kühlung und Benetzung zu verstehen.

Mehrskalenanalyse
Neuartige Materialien müssen mit immer höherer Auflösung analysiert werden, wobei der größere Kontext der Probe erhalten bleiben muss. Die Mehrskalenanalyse ermöglicht die Korrelation verschiedener Geräte und Modalitäten zur Bildgebung wie Röntgen-Mikro-CT, DualBeam, Laser-PFIB, REM und TEM.

3D-Materialcharakterisierung
Die Entwicklung von Materialien erfordert oft eine 3D-Multiskalen-Charakterisierung. DualBeam-Geräte ermöglichen das serielle Schneiden großer Volumina und die anschließende REM-Bildgebung im Nanometerbereich, die zu hochwertigen 3D-Rekonstruktionen der Probe verarbeitet werden kann.

Querschnitte
Querschnitte bieten zusätzliche Einblicke, indem sie Informationen über tieferliegende Bereiche aufdecken. DualBeam-Geräte verfügen über hervorragende FIB-Säulen für hochwertige Querschnitte. Mit der Automatisierung ist eine unbeaufsichtigte Hochdurchsatzverarbeitung von Proben möglich.
Laserablation für Halbleiter
Die Laserablation ermöglicht das Abtragen von Halbleiterbauelementen im Hochdurchsatz für die Bildgebung und Analyse mittels Elektronenmikroskopie bei gleichzeitiger Erhaltung der Probenintegrität. Greifen Sie auf 3D-Daten mit großem Volumen zu und optimieren Sie die Abtragungsbedingungen, um sie auf die für Ihren Probentyp beste Weise zu nutzen.
Nanosondierung
Je komplexer das Gerät ist, um so mehr Stellen existieren, an denen sich Defekte verstecken können. Nanosondierung ermöglicht die präzise Lokalisierung von elektrischen Fehlern, was für eine effektive Fehleranalyse mittels Transmissionselektronenmikroskopie entscheidend ist.
Entschichtung von Bauelementen
Immer kleinere Bauelemente und fortschrittliches Design und Architektur führen zu immer größeren Herausforderungen bei der Fehleranalyse von Halbleitern. Die schadensfreie Entschichtung von Bauelementen ist ein wichtiges Verfahren für die Erkennung von verborgenen elektrischen Fehlern und Ausfällen.

(S)TEM-Probenvorbereitung
DualBeam-Mikroskope ermöglichen die Vorbereitung hochwertiger, ultradünner Proben für die (S)TEM-Analyse. Dank fortschrittlicher Automatisierung können Anwender jeder Erfahrungsstufe für eine Vielzahl von Materialien Ergebnisse auf Expertenebene erzielen.

APT-Probenvorbereitung
Die Atomsondentomographie (Atom Probe Tomography, APT) ermöglicht die 3D-Kompositionsanalyse von Materialien mit atomarer Auflösung. Die Mikroskopie mit fokussiertem Ionenstrahl (Focused Ion Beam, FIB) ist eine äußerst wichtige Technologie für eine qualitativ hochwertige, ausrichtungs- und ortsspezifische Probenpräparation für die APT-Charakterisierung.

In-situ-Experimente
Die direkte Echtzeitbeobachtung mikrostruktureller Veränderungen mit der Elektronenmikroskopie ist notwendig, um die Grundprinzipien dynamischer Prozesse wie Rekristallisation, Kornwachstum und Phasenumwandlung während der Erwärmung, Kühlung und Benetzung zu verstehen.

Mehrskalenanalyse
Neuartige Materialien müssen mit immer höherer Auflösung analysiert werden, wobei der größere Kontext der Probe erhalten bleiben muss. Die Mehrskalenanalyse ermöglicht die Korrelation verschiedener Geräte und Modalitäten zur Bildgebung wie Röntgen-Mikro-CT, DualBeam, Laser-PFIB, REM und TEM.

3D-Materialcharakterisierung
Die Entwicklung von Materialien erfordert oft eine 3D-Multiskalen-Charakterisierung. DualBeam-Geräte ermöglichen das serielle Schneiden großer Volumina und die anschließende REM-Bildgebung im Nanometerbereich, die zu hochwertigen 3D-Rekonstruktionen der Probe verarbeitet werden kann.

Querschnitte
Querschnitte bieten zusätzliche Einblicke, indem sie Informationen über tieferliegende Bereiche aufdecken. DualBeam-Geräte verfügen über hervorragende FIB-Säulen für hochwertige Querschnitte. Mit der Automatisierung ist eine unbeaufsichtigte Hochdurchsatzverarbeitung von Proben möglich.
Laserablation für Halbleiter
Die Laserablation ermöglicht das Abtragen von Halbleiterbauelementen im Hochdurchsatz für die Bildgebung und Analyse mittels Elektronenmikroskopie bei gleichzeitiger Erhaltung der Probenintegrität. Greifen Sie auf 3D-Daten mit großem Volumen zu und optimieren Sie die Abtragungsbedingungen, um sie auf die für Ihren Probentyp beste Weise zu nutzen.
Nanosondierung
Je komplexer das Gerät ist, um so mehr Stellen existieren, an denen sich Defekte verstecken können. Nanosondierung ermöglicht die präzise Lokalisierung von elektrischen Fehlern, was für eine effektive Fehleranalyse mittels Transmissionselektronenmikroskopie entscheidend ist.
Entschichtung von Bauelementen
Immer kleinere Bauelemente und fortschrittliches Design und Architektur führen zu immer größeren Herausforderungen bei der Fehleranalyse von Halbleitern. Die schadensfreie Entschichtung von Bauelementen ist ein wichtiges Verfahren für die Erkennung von verborgenen elektrischen Fehlern und Ausfällen.
Electron microscopy services
To ensure optimal system performance, we provide you access to a world-class network of field service experts, technical support, and certified spare parts.