Search
Thermo Scientific AutoTEM 5 Software is a unique solution for DualBeam (focused ion beam scanning electron microscopy, FIB-SEM) systems, supporting fully automated, in situ transmission electron microscopy (TEM) sample preparation for a wide range of materials science samples. It provides fast, reliable, and repeatable results for users with any experience level.
High quality
High quality S/TEM sample preparation for users of any experience level in less than one hour.
Complete workflow
Complete in situ S/TEM sample preparation workflow, including automated chunking, user guided lift-out and automated final thinning.
Automated in-situ sample preparation
Fully automated in-situ sample preparation using different geometries: top down, plan view and inverted.
Robust results
Robust, predictable results for a wide range of material science samples
High throughput
High throughput with fully automated, unattended multi-site in-situ and ex-situ lift out and auto cross-section capabilities.
Highly configurable workflow
Highly configurable workflow to enable preparation of challenging samples.
Manual preparation | AutoTEM 5 Software | ||
|---|---|---|---|
Materials | Metals and alloys | ||
Semiconductors | |||
Polymers and ceramics | |||
Process coverage | Chunk milling | Manual | Fully automated or interactive |
Lift-out process | Manual | ||
Final thinning | Manual | ||
Low-energy polishing | Manual | ||
Specifications | Throughput | 60 – 120 mins | < 45 mins |
High quality | User dependent | Protocol dependent | |
Repeatability | - | ||
Overnight runs | - | ||
User | Experience level | Expert | Beginner |

Grundlagenforschung in der Materialforschung
Neuartige Materialien werden in immer kleineren Dimensionen untersucht, um ihre physikalischen und chemischen Eigenschaften bestmöglich zu kontrollieren. Die Elektronenmikroskopie gibt Forschern wichtige Einblicke in eine Vielzahl von Materialeigenschaften auf der Mikro- bis Nanoebene.
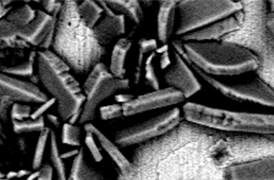
Prozesskontrolle mittels Elektronenmikroskopie
Die moderne Industrie verlangt einen hohen Durchsatz bei erstklassiger Qualität. Diese Balance wird durch eine robuste Prozesskontrolle aufrechterhalten. REM- und TEM-Geräte mit spezieller Automatisierungssoftware bieten schnelle, mehrskalige Informationen für die Überwachung und Verbesserung von Prozessen.

Qualitätskontrolle und Fehleranalyse
Qualitätskontrolle und Qualitätssicherung sind in der modernen Industrie von entscheidender Bedeutung. Wir bieten eine Reihe von EM- und Spektroskopiegeräten für die mehrskalige und multimodale Analyse von Mängeln, mit denen Sie zuverlässige und fundierte Entscheidungen für die Kontrolle und Verbesserung von Prozessen treffen können.

Pathfinding und Entwicklung von Halbleitern
Fortschrittliche Elektronenmikroskopie, fokussierter Ionenstrahl und zugehörige Analyseverfahren zur Identifizierung umsetzbarer Lösungen und Designmethoden für die Herstellung von leistungsstarken Halbleiterbauelementen.

Ausbeutesteigerung und Metrologie
Wir bieten fortschrittliche Analysemöglichkeiten für die Fehleranalyse, Metrologie und Prozesskontrolle, die die Produktivität erhöhen und die Ausbeute bei zahlreichen Halbleiteranwendungen und Halbleiterbauelementen verbessern.

Fehleranalyse von Halbleitern
Durch immer komplexere Strukturen von Halbleiterbauelementen können sich an mehr Stellen folgenschwere Mängel verbergen. Mit unseren Arbeitsabläufen der nächsten Generation können Sie auch kleinste Probleme in der Elektrik lokalisieren und charakterisieren, die sich auf die Ausbeute, Leistung und Zuverlässigkeit auswirken.

Physikalische und chemische Charakterisierung
Die kontinuierliche Nachfrage der Verbraucher treibt die Entwicklung kleinerer, schnellerer und kostengünstigerer elektronischer Geräte voran. Ihre Fertigung basiert auf hoch produktiven Geräten und Arbeitsabläufen, die eine breite Palette von Halbleiterbauelementen und Anzeigegeräten abbilden, analysieren und charakterisieren.

(S)TEM-Probenvorbereitung
DualBeam-Mikroskope ermöglichen die Vorbereitung hochwertiger, ultradünner Proben für die (S)TEM-Analyse. Dank fortschrittlicher Automatisierung können Anwender jeder Erfahrungsstufe für eine Vielzahl von Materialien Ergebnisse auf Expertenebene erzielen.

Querschnitte
Querschnitte bieten zusätzliche Einblicke, indem sie Informationen über tieferliegende Bereiche aufdecken. DualBeam-Geräte verfügen über hervorragende FIB-Säulen für hochwertige Querschnitte. Mit der Automatisierung ist eine unbeaufsichtigte Hochdurchsatzverarbeitung von Proben möglich.

Mehrskalenanalyse
Neuartige Materialien müssen mit immer höherer Auflösung analysiert werden, wobei der größere Kontext der Probe erhalten bleiben muss. Die Mehrskalenanalyse ermöglicht die Korrelation verschiedener Geräte und Modalitäten zur Bildgebung wie Röntgen-Mikro-CT, DualBeam, Laser-PFIB, REM und TEM.
Bildgebung und Analyse mittels TEM für Halbleiter
Thermo Fisher Scientific Transmissionselektronenmikroskope bieten die hochauflösende Bildgebung und Analyse von Halbleiterbauelementen, mit denen Hersteller Werkzeuge kalibrieren, Fehlermechanismen diagnostizieren und die Gesamtprozesserträge optimieren können.
TEM-Messtechnik
Fortschrittliche und automatisierte TEM-Messroutinen liefern eine deutlich höhere Präzision als manuelle Methoden. Dadurch können Anwender große Mengen statistisch relevanter Daten mit Spezifität im Sub-Angstrom-Bereich erzeugen, die frei von Bedienereinflüssen ist.
Probenvorbereitung von Halbleiterbauelementen
Thermo Scientific DualBeam Systeme bieten genaue eine TEM-Probenvorbereitung für die Analyse von Halbleiterbauelementen im atomaren Maßstab. Automatisierung und fortschrittliche Machine-Learning-Methoden erzeugen qualitativ hochwertige Proben am richtigen Ort und zu niedrigen Kosten pro Probe.
Laserablation für Halbleiter
Die Laserablation ermöglicht das Abtragen von Halbleiterbauelementen im Hochdurchsatz für die Bildgebung und Analyse mittels Elektronenmikroskopie bei gleichzeitiger Erhaltung der Probenintegrität. Greifen Sie auf 3D-Daten mit großem Volumen zu und optimieren Sie die Abtragungsbedingungen, um sie auf die für Ihren Probentyp beste Weise zu nutzen.

(S)TEM-Probenvorbereitung
DualBeam-Mikroskope ermöglichen die Vorbereitung hochwertiger, ultradünner Proben für die (S)TEM-Analyse. Dank fortschrittlicher Automatisierung können Anwender jeder Erfahrungsstufe für eine Vielzahl von Materialien Ergebnisse auf Expertenebene erzielen.

Querschnitte
Querschnitte bieten zusätzliche Einblicke, indem sie Informationen über tieferliegende Bereiche aufdecken. DualBeam-Geräte verfügen über hervorragende FIB-Säulen für hochwertige Querschnitte. Mit der Automatisierung ist eine unbeaufsichtigte Hochdurchsatzverarbeitung von Proben möglich.

Mehrskalenanalyse
Neuartige Materialien müssen mit immer höherer Auflösung analysiert werden, wobei der größere Kontext der Probe erhalten bleiben muss. Die Mehrskalenanalyse ermöglicht die Korrelation verschiedener Geräte und Modalitäten zur Bildgebung wie Röntgen-Mikro-CT, DualBeam, Laser-PFIB, REM und TEM.
Bildgebung und Analyse mittels TEM für Halbleiter
Thermo Fisher Scientific Transmissionselektronenmikroskope bieten die hochauflösende Bildgebung und Analyse von Halbleiterbauelementen, mit denen Hersteller Werkzeuge kalibrieren, Fehlermechanismen diagnostizieren und die Gesamtprozesserträge optimieren können.
TEM-Messtechnik
Fortschrittliche und automatisierte TEM-Messroutinen liefern eine deutlich höhere Präzision als manuelle Methoden. Dadurch können Anwender große Mengen statistisch relevanter Daten mit Spezifität im Sub-Angstrom-Bereich erzeugen, die frei von Bedienereinflüssen ist.
Probenvorbereitung von Halbleiterbauelementen
Thermo Scientific DualBeam Systeme bieten genaue eine TEM-Probenvorbereitung für die Analyse von Halbleiterbauelementen im atomaren Maßstab. Automatisierung und fortschrittliche Machine-Learning-Methoden erzeugen qualitativ hochwertige Proben am richtigen Ort und zu niedrigen Kosten pro Probe.
Laserablation für Halbleiter
Die Laserablation ermöglicht das Abtragen von Halbleiterbauelementen im Hochdurchsatz für die Bildgebung und Analyse mittels Elektronenmikroskopie bei gleichzeitiger Erhaltung der Probenintegrität. Greifen Sie auf 3D-Daten mit großem Volumen zu und optimieren Sie die Abtragungsbedingungen, um sie auf die für Ihren Probentyp beste Weise zu nutzen.
Electron microscopy services
To ensure optimal system performance, we provide you access to a world-class network of field service experts, technical support, and certified spare parts.




